上海奔普仪器科技有限公司
>> 行业资讯热分析技术在PCB失效分析中的应用
1 热分析技术
1.1 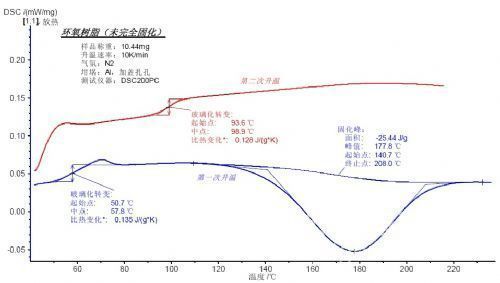 (DSC)
(DSC)
差示扫描量热法(Differential Scanning Calorimetry)是在程序控温下,测量输入到物质与参比物质之间的功率差与温度(或时间)关系的一种方法。DSC 在试样和参比物容器下装有两组补偿加热丝,当试样在加热过程中由于热效应与参比物之间出现温差ΔT 时,可通过差热放大电路和差动热量补偿放大器,使流入补偿电热丝的电流发生变化,而使两边热量平衡,温差ΔT 消失,并记录试样和参比物下两只电热补偿的热功率之差随温度(或时间)的变化关系,并根据这种变化关系,可研究分析材料的物理化学及热力学性能。DSC 的应用广泛,但在PCB 的分析方面主要用于测量PCB 上所用的各种高分子材料的固化程度(例如图2)、玻璃态转化温度,这两个参数决定着PCB 在后续工艺过程中的可靠性。
例2 PCB 中的环氧树脂的固化情况分析
1. 2 热机械分析仪 (TMA)
热机械分析技术(Thermal Mechanical Analysis)用于程序控温下,测量固体、液体和凝胶在热或机械力作用下的形变性能,常用的负荷方式有压缩、针入、拉伸、弯曲等。测试探头由固定在其上面的悬臂梁和螺旋弹簧支撑,通过马达对试样施加载荷,当试样发生形变时,差动变压器检测到此变化,并连同温度、应力和应变等数据进行处理后可得到物质在可忽略负荷下形变与温度(或时间)的关系。根据形变与温度(或时间)的关系,可研究分析材料的物理化学及热力学性能。TMA 的应用广泛,在PCB 的分析方面主要用于PCB 最关键的两个参数:测量其线性膨胀系数和玻璃态转化温度。膨胀系数过大的基材的PCB 在焊接组装后常常会导致金属化孔的断裂失效。
1. 3 热重分析仪 (TGA)
热重法(Thermogravimetry Analysis)是在程序控温下,测量物质的质量随温度(或时间)的变化关系的一种方法。TGA 通过精密的电子天平可监测物质在程控变温过程中发生的细微的质量变化。根据物质质量随温度(或时间)的变化关系,可研究分析材料的物理化学及热力学性能。TGA 在研究化学反应或物质定性定量分析方面有广泛的应用;在PCB 的分析方面,主要用于测量PCB 材料的热稳定性或热分解温度,如果基材的热分解温度太低,PCB 在经过焊接过程的高温时将会发生爆板或分层失效现象。
2 典型的失效案例
由于PCB 失效的类型和原因众多,且本文篇幅有限,下面将选择几个典型爆板的案例进行介绍,重点介绍上述热分析技术的运用以及解决问题的基本思路,分析的过程则省略。
案例一 PCB 局部爆板分析
该批样品为CEM1 类型板材,无铅回流焊后发生爆板失效,概率达3%左右,样品呈长条型,其中有一排较大地电磁继电器(见图1)。爆板的区域集中在元器件分布少的部位,且该部位和对应的背面的颜色较黄,颜色较其他部位要明显深(图2)。通过切片分析发现,爆板发生的区域内部PCB 基材分层在纸质层。用近似批次的样板按照进行热应力试验,在260℃下由10 秒到30 秒都没有发现类似的爆板失效,试验后的样品的颜色也没有实际失效的样品深。同时用热分析方法(TGA 和DSC)对爆板区域的材质进行,发现该材质的热分解温度和玻璃态转化温度均符合材质的技术规范。根据以上分析,可以推断该无铅回流焊组装工艺的条件超出了该类型PCB 的技术要求,回流时为了保证吸热的大器件的焊点合格或良好,设置的工艺参数主要是焊接的温度与时间过高过长,导致元器件少或空白的区域局部温度超过该类型板材的技术规范,最终导致产品爆板失效。该失效与板材本身无关,而与材质的选用、设计以及焊接工艺有关。
实际上,业界的PCB 爆板案例大多与板材选用不当相关,主要是热分解温度过低或水分含量过高造成,而本案例则例外。
案例二 PCB 回流焊后爆板
该批PCB 样品在经历无铅回流焊后发生爆板现象,失效样品爆板位置主要分布在器件较少和大铜面位置,经过切片分析发现爆板分层位置在纸层内部(图3)。然后对同一批次的PCB 空白板进行260 度10秒的热应力试验,只发现部分爆板现象。最后我们分别使用TGA 与DSC 分析技术分析了板材的玻璃态转化温度Tg 与分解温度Td(见图4),结果显示,板材的Tg 约132 度,而Td 只有246 度。
由于失效样品爆板位置主要分布在器件较少和大铜面位置,在无铅回流焊接过程中,该位置由于热容量较大器件位置小,且大铜面吸热更多,从而造成样品失效部位的温度较别处偏高,失效部位的颜色较深也证明了上述结论。对PCB 材料的热分解温度测试结果表明,该PCB 的热分解温度为246.6℃,考虑到无铅回流焊接工艺下,焊接最高温度通常为245℃~255℃,显然,在回流焊接过程中,样品器件较少位置的大器件对应的背面位置研磨方向纸层开裂玻纤层温度和PCB 热分解温度接近甚至更高,而当焊接温度超过PCB 热分解温度时,PCB 将发生热分解产生气体,气体膨胀产生的应力将导致PCB 爆板分层。由于该失效样品的热分解温度和焊接最高温度相接近,从而导致一定比例的爆板失效。
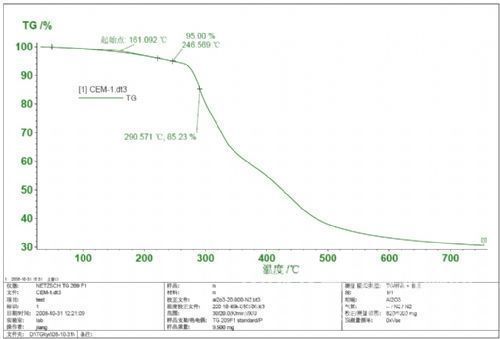
案例三 PCBA 局部爆板
一批PCBA 样品其中的某个QFP 器件边缘气泡鼓起(见图5),PCB 内部分离界面在铜箔与PP层之间。经过包括热应力、玻璃态温度分析、分解温度分析与模拟工艺试验等一系列的试验都没有发现类似现象和参数不合格的问题。最后在用TMA 分析材料的Z 轴的膨胀系数(Z-CTE)时发现(图6),基材的膨胀系数无论在低于或高于Tg 段的系数都超过标准范围。
PCB 材料本身的Z-CTE 相对较高,在无铅回流焊接过程中升温段树脂与金属铜箔的膨胀系数的不匹配(Z 轴)导致PCB 受热膨胀,在随后的降温过程中,PCB 变形逐渐恢复,但是在器件下端,由于首先凝固的SOP 焊点的约束作用,导致其下PCB 无法恢复,并产生较大的纵向应力,当其纵向应力大于铜箔与树脂之间的粘合力时,将导致该位置PCB 内部分层。而焊接面由于不存在QFP 引脚的限制可以自由回缩,因此失效主要发生在靠近QFP 器件面的芯板树脂与铜箔界面。另一方面由于该位置处焊盘及通孔的分布和结构特点造成该处应力不容易释放,导致该位置较其它位置更易发生爆板失效,因此该处焊盘设计特征是加剧爆板的一个因素。
- ・电子天平在应用超级单体传感器之后的又一次革命
- ・冷光源黑光灯在渗透检测中污染物和缺陷的区别
- ・雷达测速反馈仪在洛阳“上岗”2套
- ・什么牌子的电子天平质量好
- ・梅特勒新款电子天平解释
- ・ST5520日本日置绝缘电阻测试仪上市
- ・QuaNix4500涂镀层测厚仪
- ・鹤壁公安局交管队开展打四非、查四违行动
- ・涂层测厚仪在客车制造厂的应用
- ・穿过涂层的超声波测厚仪原理分析
- ・赛多利斯称量无止境,创想无极限――六月幸运创意之星
- ・新款在线水流测速仪隆重上市
- ・沈阳增96个“电子警察” 近期上岗
- ・奥豪斯ADVENTURER™ PRO电
- ・铁岭市公安局交通警察支队购置移动高清测速仪询价采购
- ・梅特勒-托利多分析仪器在石油化工行业的应用
- ・表面光洁度与表面粗糙度参数换算表
- ・时代涂层测厚仪在使用中的常见问题分析
- ・直流稳压电源工作原理
- ・硬度计的应用领域分类
- 目前还没有同类品牌商品!
- ・使用环氧厚浆处理混凝土碳化的分析
- ・北方奥钛注重科研促发展
- ・仪器仪表的故障诊断方法
- ・HRC洛氏硬度计的测量原理是什么
- ・温度传感器的应用及原理
- ・黑龙江森林植物园在我司购买梅特勒电子天平ME204
- ・我国仪器仪表行业投资分析及前景预测
- ・海洋仪器仪表研究所助推海洋强国梦
- ・2014年国产高端仪器设备国外受欢迎
- ・全球塑料机械整体需求分析
- ・国际企业“图谋”我国基层医疗器械市场
- ・艾默生推出1/2英寸67D系列仪器用调压器
- ・日立开发出毫米波雷达绝对速度传感器技术
- ・世卫预计6月底可做好生产甲型H1N1流感疫苗准备
- ・行李缠绕机简介
- ・仪器仪表行业本身的特点是导致发展缓慢的原因之一
- ・纯水器市场需求和购买率保持逐年上升势头
- ・湖北对基因检测行业全面监管
- ・国内电工仪器仪表产品市场透析
- ・安捷伦与成都前锋合作化解合资风险
- ・我国仪器仪表行业投资分析及前景预测
- ・海洋仪器仪表研究所助推海洋强国梦
- ・2014年国产高端仪器设备国外受欢迎
- ・全球塑料机械整体需求分析
- ・国际企业“图谋”我国基层医疗器械市场
- ・艾默生推出1/2英寸67D系列仪器用调压器
- ・日立开发出毫米波雷达绝对速度传感器技术
- ・世卫预计6月底可做好生产甲型H1N1流感疫苗准备
- ・行李缠绕机简介
- ・仪器仪表行业本身的特点是导致发展缓慢的原因之一
- ・纯水器市场需求和购买率保持逐年上升势头
- ・湖北对基因检测行业全面监管
- ・国内电工仪器仪表产品市场透析
- ・安捷伦与成都前锋合作化解合资风险
- ・高光谱与高空间集成研究通过验收
- ・世界首台超高分辨率光电子能谱仪研制成功
- ・2005年起香港仪器仪表分批实行零关税
- ・精确预计流动分叉获得新理论途径
- ・仪器仪表发展简史与现代社会的密切关系
- ・中科院光电所生物芯片仪器研发水平稳步提升
| 公司重点推荐仪器: | ||||
| 雷达测速仪 | 涂层测厚仪 | 粗糙度仪 | 硬度计 | 激光测距仪 |
| 电子天平 | 噪音计 | 照度计 | 风速计 | 温湿度计 |
| 超声波测厚仪 | 紫外线灯 | 频闪仪 | 测振仪 | 红外热像仪 |
| 直流稳压电源 | 安规测试仪 | 转速表 | 示波器 | LCR测试仪 |
| 信号发生器 | 万用表 | 兆欧表 | 相序表 | 耐压测试仪 |
| 酸度计 | 电导率仪 | 推拉力计 | 浊度仪 | 卤素检漏仪 |
| 接地电阻测试仪 | 红外测温仪 | 钳形表 | 溶氧仪 | 电火花检测仪 |
| 公司重点推荐仪器厂家品牌: | ||||
| 日本万用 | 美国雷泰 | 美国蒙拿多 | 时代集团 | 意大利哈纳仪器 |
| 日本理音 | 美国泰克 | 美国GE | 美国FLIR | 德国菲希尔 |
| 日本共立 | 美国Dakota | 台湾泰仕 | 瑞士徕卡 | 德国尼克斯 |
| 日本日置 | 美国斯德克 | 台湾群特 | 德国KK | 梅特勒-托利多 |
| 日本新宝 | 美国福禄克 | 台湾固纬 | 美国路阳 | 美国奥豪斯OHAUS |
| 日本加野麦克斯 | 美国安捷伦 | 台湾先弛 | 香港CEM | 德国赛多利斯 |
| 德国德图 | 美国英思科 | 台湾一诺 | 台湾衡欣 | 常州同惠 |
客服邮箱:tech17@126.com 客服电话:021-31266107 邮政编码:201199
公司地址:上海市沁春路1366弄38号803室 网站地址:www.17360.cn
Copyright © 2005-2014 上海奔普仪器科技有限公司 All Rights Reserved.
网站备案:沪ICP备05008086号

